第一章 半导体器件
半导体介于导体与绝缘体之间 导体-低价元素 绝缘体-高价元素 半导体-硅(si),锗(Ge),四价元素
1.半导体基础
本征半导体
- 单质半导体材料是具有四价共价键晶体结构的硅Si和锗Ge。
- 导体能力介于导体与绝缘体之间
- 特性:光敏,热敏和掺杂特性。
- 本征半导体:纯净的,具有完整晶体结构的半导体。在一定温度下,本征半导体内最重要的物理现象是本征激发(又称热激发),产生两种带电性质向相反的载流子(空穴和自由电子对),温度越高,本征激发越强。
- 空穴是半导体中的一种等效+q的载流子。空穴导电的本质是价电子依次填补本征晶体中空位,使局部显示+q的空位宏观定向运动。
- 在一定温度下,自由电子和空穴在热运动中相遇,使一对自由电子和空穴消失的现象称为复合。当热激发和复合相等时,称为载流子处于动态平衡状态。
主要运动:扩散运动,复合运动 导电性能差,与温度密切相关
杂质半导体
在本征半导体中掺入微量杂质形成的半导体。体现的是半导体的掺杂特性。
- P(positive)型半导体:在本征半导体中掺入微量的3价元素如硼B(多子是空穴,少子是电子)
- N(negative)型半导体:在本征半导体中掺入微凉的5价元素如磷P(多子是电子,少子是空穴)。
杂质半导体的特性
- 载流子的浓度:多子浓度决定杂质浓度,几乎与温度无关;少子浓度是温度的敏感函数。
- 体电阻:通常把杂质半导体自身的电阻称为体电阻。
- 在半导体中,存在因电场作用产生的载流子漂移电流(与金属导电一致),还能在因浓度差产生的扩散电流。
浓度差产生的电流称为扩散运动 电场力作用下,载流子的运动称为漂移运动。
PN结
在具有完整晶格的P型和N型半导体的物理界面附近,形成一个特殊的薄层(PN结)。 PN结中存在由N区指向P区的内建电场(因为多子的扩散使得不可移动的离子显性,P区是负离子,N区是正离子,所以内建电场由N区指向P区),阻止结外两区的多子的扩散,有利于少子的漂移。 PN结具有单向导电性:正偏导通,反偏截止,是构成半导体器件的核心器件。
-
正偏PN结(P+,N-):具有随电压指数增大的电流,硅材料约为0.6-0.8V,锗材料约为0.2-0.3V。
-
反向PN结(P-,N+):在击穿前,只有很小的反向饱和电流Is。

图中参数:
击穿电压UBR
反向饱和电流Is
开启电压Uon
- 若正向电压$u>>UT$(与误差要求有关),则$i=Ise^{uT}$(指数曲线)
- 若反向电压$|u|>>UT$,则$i ≈-Is$(平行线)
$T ↑$->在电流不变的情况下管压降,$u ↓$ ,反向$Is ↑ $$Ubr ↑$->正向特性左移,反向特性下移
-
PN结的伏安方程: $ i=Is(e^{\frac{qu}{kT}}-1)=Is(e^{\frac{u}{UT}}-1)$( U T 为 温 度 的 电 压 当 量 ) Is为反向饱和电流,q为电子的电量,k为玻尔兹曼常数
T为热力学温度,$UT=\frac{kT}{q}$,常温下$UT=26mA(T=300k)$
Si和Ge的参数对比
| 材料 | 开启电压 | 导通电压 | 反向饱和电流 |
|---|---|---|---|
| Si | 0.5V | 0.5~0.8V | 1uA以下 |
| Ge | 0.7V | 0.1~0.3V | 几十uA |
*导通电压非常量,不一定是0.7
PN结的的电容效应
势垒电容Cb:外加反向电压时,空间电荷区的电荷积累与释放。 扩散电容Cd:外加正向电压时,扩散运动的电荷的积累和释放。 结电容Cj=Cb+Cd pn结所加频率如果高于一定值,将失去单向导电性
2.半导体二极管
二极管(英语:Diode),是一种具有不对称电导的双电极电子元件。理想的二极管在正向导通时两个电极(阳极和阴极)间拥有零电阻,而反向时则有无穷大电阻,即电流只允许由单一方向流过二极管。
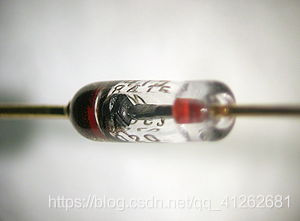
三种结构:
1.点接触型,结电容小,适用于高频电路和小功率整流。 2.面接触式,结电容大,只适合在较低频率下工作 3.平面二极管,结电容大的用于大功率整流,结电容小的用作脉冲数字电路中的开关管。 二极管的主要参数: 1.最大整流电流$I_F$ 二极管长期运行时允许通过的最大正向平均电流。 2.最高反向工作电压$U_R$
$ U_R$是二极管工作时允许外加的最大反向电压,超过此值,二极管将有可能反向击穿。通常 $U_R$为击穿电压$ U_{(BR)}$的一半 3.反向电流$ I_R$ $I_R$是二极管未击穿是的反相电流。$ I_R$愈小,二极管的单向导电性愈好, $I_R$对温度非常敏感。 4.最高工作频率 $f_M$ $ f_M$是二极管工作的上限截止频率。超过此值时,由于结电容,二极管不能很好的体现出单向导电性。 二极管的三个等效电路

具体问题具体分析 微变等效电路
在微小的交流信号下,二极管等效一个动态电阻 $ r_d$,且$ r_d=\vartriangle u_D/\vartriangle i_D$,利用二极管的电流方程求出$r_d$ $\frac{1}{r_d}=\frac{\vartriangle u_D}{\vartriangle i_D}\approx\frac{d[I_S(e^{\frac{u}{U_T}}-1)]}{du}\approx\frac{I_S}{U_T}\cdot e^{\frac{u}{U_T}}\approx \frac{I_D}{U_T}$
$ r_d\approx \frac{U_T}{I_D}$
是Q点的电流。由于二极管正向特性为指数曲线,所以Q点越高,$r_d$的数值越小
几个二极管

稳压二极管 是利用二极管在反向电压作用下的齐纳击穿(崩溃)效应,制造而成的一种具有稳定电压功能的电子技术组件,因此又称为“稳压管”。 稳压管的参数 1.稳定电压$ U_Z$ $U_Z$是规定电流下稳压管的反向击穿电压。 2.稳定电流 $ I_Z$ $ I_Z$是稳压管工作在稳压状态下的参考电流,电流低于此值稳压效果变坏,甚至根本不稳压,故也常将$ I_Z$作为 $ I_{Zmin}$。 3.额定功耗$P_{ZM}$: $P_{ZM}$等于稳压管 的稳定电压$U_Z$和最大稳定电流$ I_{ZM}$的乘积。稳压管的功耗超过此值时,会因温度升高烧坏。 4.动态电阻 $ r_z$ $ r_z$是稳压管工作在稳压区,端电压变化量与其电流变化量之比,即$r_d=\vartriangle U_Z/\vartriangle I_Z$, $ r_z$越小,稳压效果越好 5.温度系数 $ \alpha$ $\alpha$表示温度每变化1摄氏度稳压值的变化量,即 $ \alpha=\vartriangle U_Z/\vartriangle T$
稳压管电路中必须串一个电阻来控制电流,这个电阻称为限流电阻
发光二极管(英语:Light-emitting diode,缩写为LED)是一种能发光的半导体电子元件,透过三价与五价元素所组成的复合光源。
光电二极管(英语:photodiode )是一种能够将光根据使用方式,转换成电流或者电压信号的光探测器。
肖特基二极管(又译萧特基二极管)是一种导通电压降较低、允许高速切换的二极管,是利用肖特基势垒特性而产生的电子元件
瞬态电压抑制二极管也称为TVS二极管,是一种保护用的电子零件,可以保护电器设备不受导线引入的电压尖峰破坏
隧道二极管(又称江崎二极管、穿隧效应二极管、穿隧二极管、透纳二极管或Tunnel Diode)是一种可以高速切换的半导体,其切换速度可到达微波频率的范围,其原理是利用量子穿隧效应。
变容二极管,是结电容随偏置电压变化而显著改变的一种特殊二极管
3.晶体三极管(BJT)
双极性晶体管(英语:bipolar transistor),全称双极性结型晶体管(bipolar junction transistor, BJT),俗称三极管,是一种具有三个终端的电子器件,这种晶体管的工作,同时涉及电子和空穴两种载流子的流动,因此它被称为双极性的,所以也称双极性载流子晶体管。
 在这里插入图片描述
在这里插入图片描述
关于NPN型硅材料晶体管: 位于中间的P区称为基区b,它很薄且杂质浓度很低;位于下层的N区是发射区e,掺杂浓度很高;位于上层的N区是集电区c,面积很大。
晶体管放大条件是发射结正向偏置且集电结反向偏置
放大原理(源自维基)
NPN型双极性晶体管可以视为共用阳极的两个二极管接合在一起。在双极性晶体管的正常工作状态下,发射结(基极与发射极之间的PN结)处于正向偏置状态,而集电结(基极与集电极之间的PN结)则处于反向偏置状态。在没有外加电压时,发射结N区的电子(该区域的多数载流子)浓度大于P区的电子浓度,部分电子将扩散到P区。同理,P区的部分空穴也将扩散到N区。这样,发射结上将形成一个空间电荷区(也称为耗尽层),产生一个内在的电场,其方向由N区指向P区,这个电场将阻碍上述扩散过程的进一步发生,从而达成动态平衡。这时,如果把一个正向电压施加在发射结上,上述载流子扩散运动和耗尽层中内在电场之间的动态平衡将被打破,这样会使热激发电子注入基极区域。在NPN型晶体管里,基区为P型掺杂,这里空穴为多数掺杂物质,而电子则为少数载流子。
从发射极被注入到基极区域的电子,一方面与这里的多数载流子空穴发生复合,另一方面,由于基极区域掺杂程度低、物理尺寸薄,并且集电结处于反向偏置状态,大部分电子将通过漂移运动抵达集电极区域,形成集电极电流。为了尽量缓解电子在到达集电结之前发生的复合,晶体管的基极区域的厚度必须远小于电子的扩散长度(diffusionlength,参见菲克定律),使得载流子扩散所需的时间短于半导体少数载流子的寿命。在现代的双极性晶体管中,基极区域厚度的典型值为十分之几微米。需要注意的是,集电极、发射极虽然都是N型掺杂,但是二者掺杂程度、物理属性并不相同,因此必须将双极性晶体管与两个相反方向二极管串联在一起的形式区分开来。
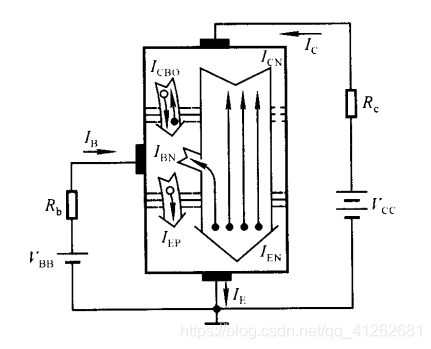
具体内部运动
集电区c:非平衡少子(从基区来的电子)的漂移运动$I_{CN}$(电场力作用下,载流子的运动称为漂移运动。),平衡少子的漂移运动$I_{CBO}$(从集电区往基区)。
基区b:(从发射区大量电子涌入基区发生的)复合运动$ I_{B}$(自由电子和空穴互抵的运动为复合运动)
发射区e:(因发射区电子浓度过大产生的)扩散运动$ I_{EN}$(浓度差产生的电流称为扩散运动) ,基区空穴的扩散运动$I_{EP}$
关系式: $I_{EN}=I_{CN}+I_{BN}$
(发射区面积大导致浓度很高,扩散到基区,后因电场力作用被拉到集电区)
$I_E=I_{EN}+I_{EP}=I_{CN}+I_{BN}+I_{EP}$(根据上式转化)
$I_{C}=I_{CN}+I_{CBO}$
$ I_{B}=I_{BN}(发射区电子流入)+I_{EP}(基区空穴流出)-I_{CBO}(集电区空穴流入)$
$=I{\prime}_B-I_{CBO}$
又上式可得 $I_E=I_B+I_C$
放大系数
电流 $I_{CN}$与 $I_B{\prime}$之比为共射直流电流放大系数 $ \overline{\beta}$
可得$ \overline{\beta}=\frac{I_{CN}}{I{\prime}B}=\frac{I_C-I{CBO}}{I_B+I_{CBO}}$
整理得 $ I_C=\overline{\beta}I_B+(1+\overline{\beta})I_{CBO}=\overline{\beta}I_B+I_{CEO}$
$ I_{CEO}$为穿透电流,就是在基极电流为0时,CE间通过的电流 $I_C\approx\overline{\beta} I_B$
$ I_E\approx(1+\overline{\beta}) I_B$
$ \vartriangle I_B$
与$ \vartriangle I_C$之比为共射交流放大系数 $\beta$ $ \beta=\frac{\vartriangle I_C}{\vartriangle I_B}$
集电结总电流$ i_c=I_C+\vartriangle i_c=\overline{\beta} I_B+I_{CEO}+\beta\vartriangle i_B$,穿透电流$ I_{CEO}$很小可忽略不计, 则 $ i_c\approx \overline{\beta} I_B+\beta\vartriangle i_B$,在$\vartriangle i_B|$不大的情况下,可以认为$\overline{\beta}\approx\beta$
当以发射极作为输入电流,以集电极作为输出电流时, I$I_{CN}$与$ I_E$之比称为共基直流电流放大系数$ \overline{\alpha}$ $ \overline{\alpha}=\frac{I_{CN}}{I_E}$
根据上面同样推导过程得 $ I_C=\overline{\alpha}I_E+I_{CBO}$
将 $ I_E\approx(1+\overline{\beta}) I_B$代入 得$ \overline{\beta}= \frac{\overline{ \alpha}}{1-\overline{\alpha}} 或 \overline{\alpha}=\frac{\overline{\beta}}{1+\overline{\beta}}$之比为共基交流放大系数$\alpha$ $\alpha=\frac{\vartriangle I_C}{\vartriangle I_E}=\frac{\beta}{1+\beta}$
通常 $\beta$>>1,所以 α ≈ 1 ;而且$\beta\approx\overline{\beta}$相同,$\alpha\approx\overline{\alpha}$;
晶体管的共射特性曲线
输入特性曲线和输出特性曲线 1.输入特性曲线 输入特性曲线是 $U_{CE}$一定下,基极电流$ i_B$与发射结压降$U_{BE}$之间的函数关系
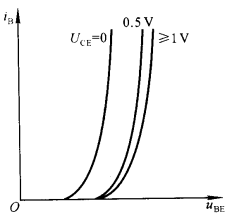
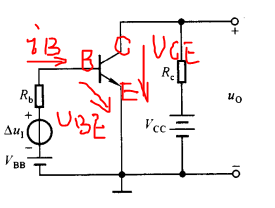
$ i_B=f(u_{BE})| {U{CE}=常数}$
- 当 $U_{CE}=0V$时,集电极与发射极短路即集电极与发射极并联。因此输入特性类似PN结的伏安特性。
- 当 $U_{CE}$增大时,曲线右移,当 $ U_{CE}$大到一定值之后,集电结的电场已足够强,可以将发射区注入基区的绝大多数非平衡少子收集到集电区,因此再增大$ U_{CE}$,$i_C$也不会明显的增大了。
对于小功率管,可以用$ U_{CE}$大于1的任何一条曲线来近似 $ U_{CE}$大于1的所有输入��性曲线
2.输出特性曲线 输出特性曲线描述基极电流I_B为一常量时,集电极电流i_c与管压降U_{CE}之间的函数关系
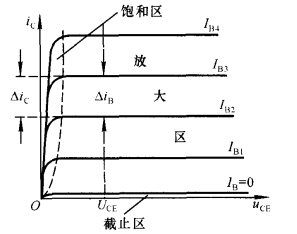
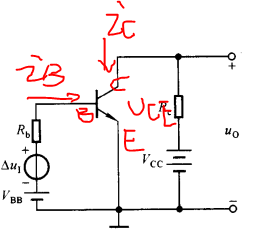
$i_C=f(u_{CE})| _{{I_B}=常数}^{}$
-
$U_{CE}$
开始增加时,集电结电场开始增强,$ i_C$逐渐增大,表现为图中饱和区
-
当 $ E U_{CE}$增大到已经把基区非平衡少子都收集过来的时候,$ i_C$将不再增加,曲线几乎平行于横轴,为图中放大区
三个工作区域 (1).截止区,发射结小于开启电压且集电结反向偏置。 (2).放大区,发射结正向偏置且集电结反向偏置。 (3).饱和区,发射结与集电结都处于正向偏置。
晶体管的主要参数
一.直流参数 1.共射直流电流放大系数$\overline{\beta}$
$\overline{\beta}=\frac{I_C-I_{CEO}}{I_B}$
$I_{C}>>I_{CEO}$时$,\overline{\beta}=\frac{I_C}{I_B}$
2.共基直流电流放大系数 $\overline{\alpha}$
当 $I_{CBO}$可忽略时, ${\alpha}=\frac{I_C}{I_E}$
3.极间反向电流 $I_{CBO}$是发射极开路时集电结的反向饱和电流,$I_{CEO}$是基极开路时,集电极与发射极之间的穿透电流, $(1+\overline{\beta})I_{CBO}=I_{CEO}$。反向电流越小,性能越稳定。
二.交流参数 1.共射交流放大系数$ \beta$ $ \beta=\frac{\vartriangle i_C}{\vartriangle i_B}|{U{CE=常数}}^{}$
选管子时,应选$\beta$适中的,太小放大能力不强,太大温度稳定性差
2.共基交流放大系数$\alpha$ $ \alpha=\frac{\vartriangle i_C}{\vartriangle i_E}|{U{CB=常数}}$
近似分析中认为 $\beta=\overline{\beta},\alpha=\overline{\alpha}=1$
3.特征频率$ f_T$ 使放大系数下降到1的信号频率称为特征频率$f_T$
三.极限参数 1.最大集电极耗散功率$P_{CM}$
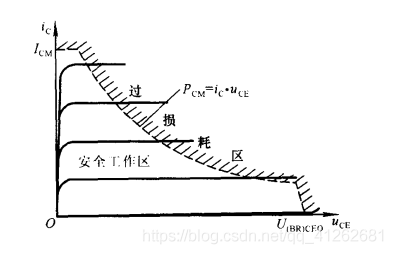
2.最大集电极电流 $ I_{CM}$ 当 $ i_c$大到一定程度时,放大系数将明显减小,这个值叫最大集电极电流$ I_{CM}$。当$ c {c}$大于 $ I{CM}$
CM时,晶体管不一定损坏,但放大系数明显下降。
3.极间反向击穿电压 $U_{(BR)CBO}$是发射极开路时,集电极-基极间的反向击穿电压。 $ U_{(BR)CEO}$是基极开路时,集电极-发射极间的反向击穿电压。 $ U_{(BR)EBO}$是集电极开路时,发射极-基极间的反向击穿电压。
温度对晶体管特性及参数的影响 一.温度对 $I_{CBO}$的影响 $ I_{CBO}$是集电结加反向电压时平衡少子的漂移运动形成的,所以当温度升高, $I_{CBO}$增大 温度每升高10℃, $ I_{CBO}$增加约一倍。硅管比锗管受温度影响要低。 由于 $ I_{CEO}$和$ I_{CBO}$的关系,$ I_{CEO}$也受温度的影响
二.温度对输入特性的影响
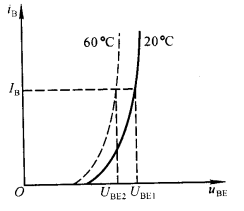
当温度升高时,正向特性左移。若 $ U_{BE}$不变,则温度升高时$ i_{B}$增大
三.温度对输出特性的影响

温度升高时,$ \beta$增大。 由于温度升高 $ I_{CEO}$, $ \beta$增大,所以导致集电极电流增大
关于PNP
书上只讲了npn的工作原理,pnp其实和npn完全相反,体现在发射极比基极电压要高,基极比集电极电压要高,也就是发射极接高电压,集电极接低电压,有的地方,集电极接负电压
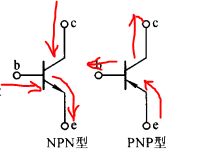
放大关系还是一样的
4.场效应管(FET)
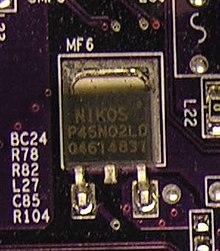
依靠电场去控制导电沟道形状,因此能控制半导体材料中某种类型载流子的沟道的导电性。场效应晶体管有时被称为“单极性晶体管”,以它的单载流子型作用对比双极性晶体管。由于半导体材料的限制,以及曾经双极性晶体管比场效应晶体管容易制造,场效应晶体管比双极性晶体管要晚造出,但场效应晶体管的概念却比双极性晶体管早。 单极性管的特点:噪声小,抗辐射能力强,低电压工作,g-s间等效电阻很大( 1 0 7 — 1 0 12 Ω 10^7—10^{12}\Omega
10
7—10
12Ω)
总体框架
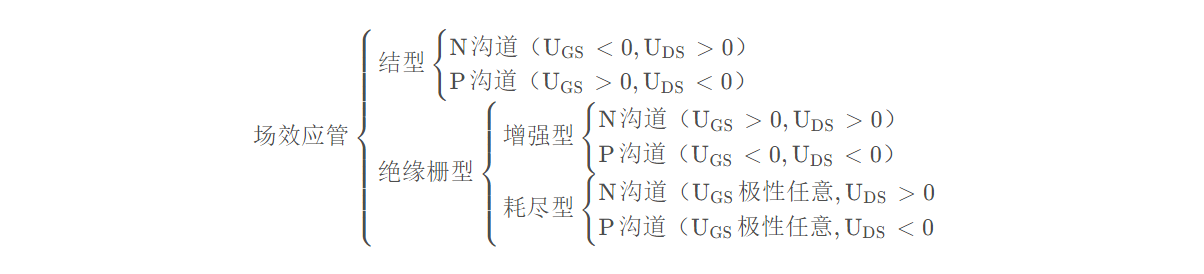
结型场效应管(JFET)
结型场效应管分为N沟道和P沟道两种类型
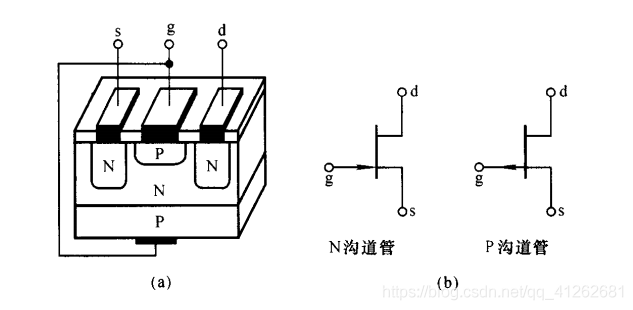
关于N沟道结型场效应管: 由P区引出的电极叫栅极g(gate),N区引出两个电极,一个为漏极d(drain),一个为源极s(source)(漏源可互换),漏极d与源极s之间的非耗尽层区域为导电沟道
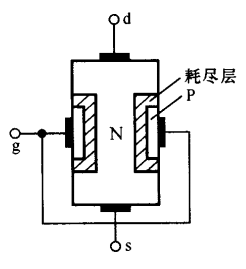
结型场效应管的工作原理
正常工作条件:栅g-源s之间加反向电压(源极s电位大于栅极g电位),即 $ U_{GS} $ <0,既保证了g-s间高内阻,又实现了 $ U_{GS} $ 对沟道电流的控制
首先:栅g—源s之间电压对导电沟道的影响
- $ U_{GS} $ =0时,导电沟道最宽,因为此时耗尽层还没有受到电场的影响。
- 在g-s之间施加反向电压(即s端接正极),耗尽层在外电场的作用下扩大,沟道变窄,注意: $ U_{GS} $ 是小于0的
- 当 $ | U_{GS}| $ 增大到一定程度也就是 $ U_{GS} $ 小到一定程度,沟道消失,两耗尽层连到一起,此时 $ U_{GS} $ 值称为夹断电压 $ U_{GS(off)} $ 。 以上注意: $ U_{GS} $ 是小于0的,漏源可互换也就是栅-漏之间电压也满足这个过程。
然后就是工作原理了 首先, $ U_{GS} $ 是小于0大于 $ U_{GS(off)} $ 的,也就是耗尽层还没连到一起 由上面的图得到一个公式 $ U_{GD}=U_{GS}-U_{DS} $ (1)我们可以控制 $ U_{DS} $ ,当 $ U_{DS} $ =0时, $ U_{GD}=U_{GS} $ ,上下都一样,耗尽层都一样宽,都没有连到一起( $ U_{GS}$ 是负的!!)
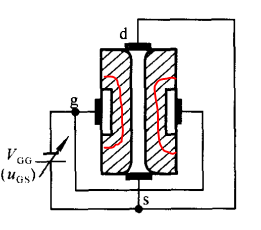
(2)然后 $ U_{DS} $ 开始增大对应 $ U_{GD} $ 开始减小,联想一下上面的耗尽层开始拓宽, 此时 $ U_{GD}$ 是大于 $ U_{GS(off)}$ 的( $ U_{GD} $ 是负的!!还没有夹断!!),这时因为没有夹断,所以漏源间电流 $ I_D $ 是随着 $ U_{DS} $ 的增大而增大的(可变电阻区)
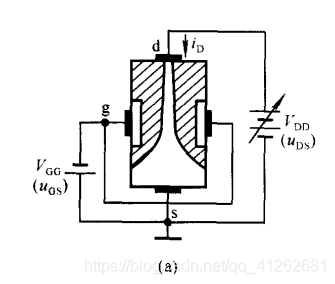
(3)当 $ U_{DS} $ 增大到一定值使得 $ U_{GD} $ 等于 $ U_{GS(off)} $ (时刻谨记这都是负的!小于才会夹断),这时是预夹断,也就是上面开始相连
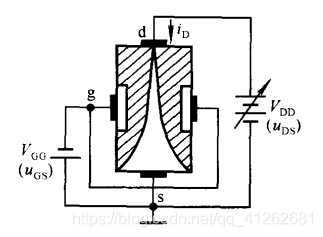
(4)当 $ U_{DS}$ 增大到一定值使得 $ U_{GD} $ 小于 $ U_{GS(off)} $ ,此时上端完全夹断,这时候, $ U_{DS} $ 的增大对 $ i_{D} $ 毫无作用,进入恒流区, $ i_{D} $ 取决于 $ U_{GS} $ 了
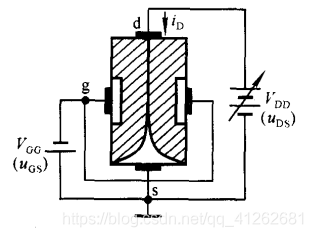
由上面过程总结: (1) $ U_{GD} $ > $ U_{GS}(off) $ , $ U_{GS}$ > $ U_{GS}(off) $ VDD增大, $ i_{D} $ 增大(可变电阻区) (2) $ U_{GD}$ = $ U_{GS}(off) $ ,预夹断 (3) $ U_{GD} $ < $ U_{GS}(off) $ VDD增大几乎都用来客服沟道的电阻, $ i_{D} $ 几乎不变,进入恒流区, $ i_{D} $ 仅取决于 $ U_{GS} $ 。 所以在恒流区,基本是 $ U_{GS} $ 控制 $ i_{D} $ ,场效应管也可以等效为电压控制电流源,用 $ g_m$ 描述动态的栅-源电压对漏极电流的控制作用, $ g_m $ 为低频跨导:
$ g_m=\frac{\vartriangle i_D}{\vartriangle U_{GS}} $
结型场效应管的特性曲线 1.输出特性曲线 输出特性曲线描述当栅-源电压 $ U_{GS} $ 为常量时,漏极电流 $ i_D $ 与漏-源电压 $ U_{DS} $ 之间的函数关系,即
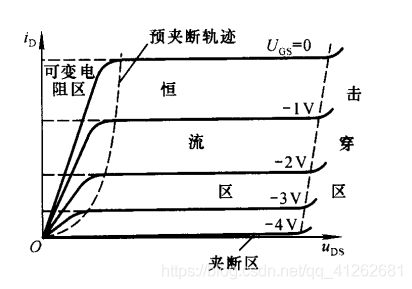
$ i_{D}=f(U_{DS})|{U{GS}=常数} $
有三个工作区域: (1)可变电阻区(也称非饱和区):该区域满足 $ U_{GD} $ > $ U_{GS(off)} $ ,虚线为预夹断轨迹,由满足 $ U_{GD} $ 等于 $ U_{GS(off)} $ 的点构成的,因为漏源间电流 $ I_D $ 是随着 $ U_{DS} $ 的增大而增大的,所以称为可变电阻区。
(2)恒流区(也称饱和区):该区域满足 $ U_{GD} $ < $ U_{GS(off)} $ ,恒流区用作放大功能。 (3)截止区:当 $ U_{GS} $ < $ U_{GS(off)}$ ,无论怎么改变 $ U_{GD} $ 都没有 $ I_D $ (很小)。
此外还有当 $ U_{DS} $ 增大到一定程度,漏极电流会突然变大,管子被击穿,这种击穿是因栅-漏间耗尽层破坏造成的,因而若栅-源击穿电压为 $ U_{(BR)GD} $ ,而漏-源击穿电压 $ U_{(BR)DS} $ 则有 $ U_{(BR)DS} = U_{GS} - U_{(BR)GD} $ ,所以当 $ U_{GS} $ 增大时,漏-源击穿电压将增大,如图击穿区。
- 转移特性曲线 转移特性曲线描述当漏-源电压 $ U_{DS} $ 为常量时,漏极电流 $ i_D $ 与栅-源电压 $ U_{GS} $ 之间的函数关系,即:

iD = f(UGS) | UDS = 常数
在输出曲线里做一个与横轴垂直的线,将其坐标信息重新绘制在iD - UGS图像上,就是转移特性曲线。iD的近似计算公式为:
$$ i_D = I_{DSS} \left(1 - \frac{U_{GS}}{U_{GS(off)}}\right)^2 \quad (U_{GS(off)} < U_{GS} < 0) $$其中$I_{DSS}$是$U_{GS}=0$的情况下产生预夹断时的电流,称为饱和漏极电流。对于N沟道管,$U_{GS} < 0$,对于P沟道管,$U_{GS} > 0$。
绝缘栅型场效应管(IGFET)
绝缘栅型场效应管的栅型,源极与漏极之间均采用SiO2绝缘层。又因栅极称为金属铝,故又称为MOS管,它的栅-源电阻比结型场效应管大的多,可达$ 10^{10}\Omega$以上,同时稳定性好,集成化工艺简单,因此广泛应用。 分为增强型和耗尽型两种。
一、N沟道增强型MOS管
以一块低掺杂的P型硅片为衬底B,利用扩散工艺制作两个高掺杂的$N^+$区,并引出两个电极,分别为源极s和漏极d,半导体上制作一层SiO2绝缘层,再在绝缘层上制作一层金属铝,引出电极,作为栅极g,通常将衬底和源极接在一起。这样衬底和栅极之间夹着绝缘层形成电容,当栅源电压发生变化时,可以改变衬底靠近绝缘层处感应电荷的多少,从而控制漏极电流的大小。
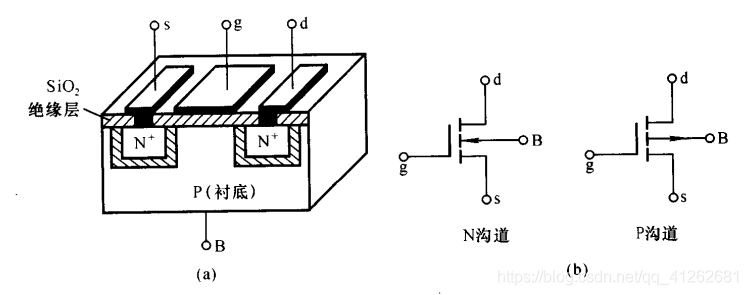
工作原理:
首先,栅 g-源 s 间电压对导电沟道的影响:
- 栅-源之间不加电压即 UGS = 0,漏源之间只是背向的 PN 结,没有导电沟道,无论漏源之间电压怎么加,都没有电流。
- UGS > 0,当栅源之间电压开始增加时,由于栅极绝缘层的存在,栅极电流为 0,但是栅极金属层将聚集正电荷,它们排斥衬底一端的空穴,使之剩下不能移动的负离子区,形成耗尽层。
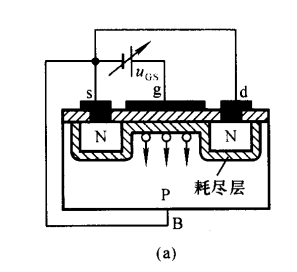
3.栅源之间电压继续增加,一方面耗尽层变宽,另一方面将衬底的自由电子吸引到耗尽层和绝缘层之间,形成了N型薄层,称为反型层,这个反型层就成了漏源之间的导电沟道,使导电沟道形成的栅-源电压称为开启电压 $U_{GS(th)}$,$U_{GS}$越大,反型层越厚,导电沟道电阻越小。
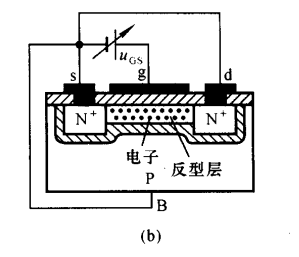
工作原理:
- UGS 为大于 UGS(th) 的一个确定值
- UGD = UGS - UDS(1)在 D-S 间加一定电压 UDS,将产生电流(可变电阻区)。
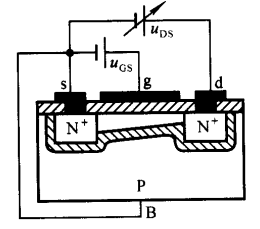
(2)当 UDS 增大到使得 UGD = UGS(th)(即 UDS = UGS - UGS(th))时,出现预夹断。
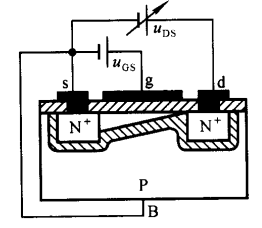
(3)UDS继续增大使得 UGD < UGS(th),右端反型层消失, UDS 全部用来克服夹断区对漏极电流的阻力,此时 iD 不受 UDS 变化而变化,取决于 UGS(恒流区)。
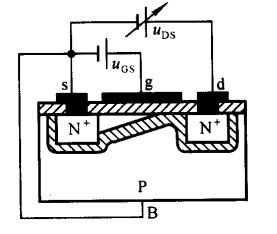
特性曲线
输出特性曲线和转移特性曲线:
输出特性曲线函数: iD = f(UDS)|{U{GS}=常数}
转移特性曲线函数: iD = f(UGS)|{U{DS}=常数}
其中,iD 表示漏极电流,UDS 表示漏-源电压,UGS 表示栅-源电压,常数表示常数值。
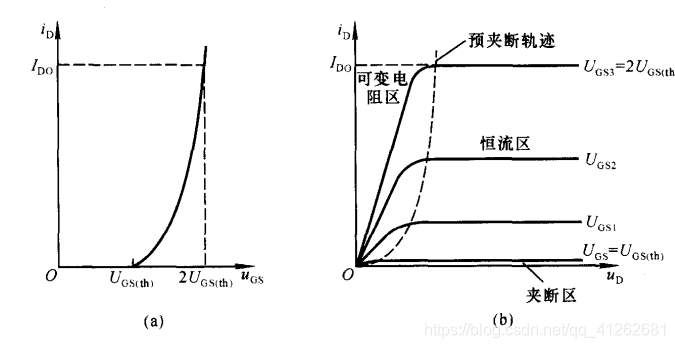
三个工作区域:
- 可变电阻区(非饱和区):UGD > UGS(th)
- 恒流区(饱和区):UGD < UGS(th)
- 夹断区:UGS < UGS(th)
iD 与 uGS 的近似关系式是: iD = Kn (uGS - uGS(th))2 = IDO (uGS/uGS(th) - 1)2
其中,IDO 是 UGS = 2UGS(th) 时的 ID。
二、N沟道耗尽型MOS管
在绝缘管中掺杂大量正离子,即在$ U_{GS}$=0时,在正离子的作用下,也存在反型层,即漏源之间存在导电沟道。只要漏源间有电压,就会产生电流。
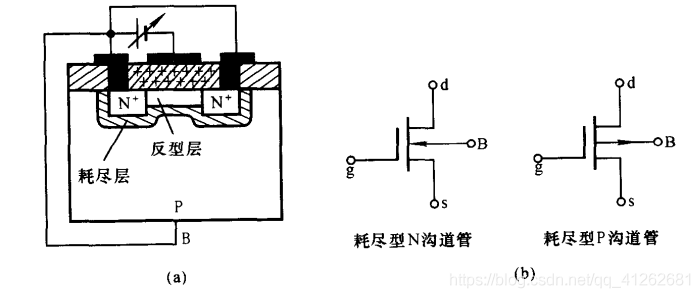 在这里插入图片描述
在这里插入图片描述
原理不再复述 直接看特性曲线
特性曲线
输出特性曲线和转移特性曲线

- 可变电阻区(非饱和区):UGD > UGS(off)
- 恒流区(饱和区):UGD < UGS(off)
- 截止区:UGS < UGS(off)
iD 与 uGS 的近似关系式是:
iD = IDSS (1 - uGS/uGS(off))2
其中,IDSS 是零栅压的漏极电流。
总结

场效应管的主要参数
一. 直流参数
-
开启电压 $U_{GS(th)}$: $U_{GS(th)}$ 是 $U_{DS}$ 为常量时,使 $i_D$ 大于零所需的最小 $|U_{GS}|$ 值。
-
夹断电压 $U_{GS(off)}$: $U_{GS(off)}$ 是 $U_{DS}$ 为常量时,使 $i_D$ 为规定的微小电流(如5ua)的 $U_{GS}$。
-
饱和漏极电流 $I_{DSS}$: 对于结型场效应管,在 $U_{GS}$ = 0V 的情况下产生预夹断时的漏极电流。
-
直流输入电阻 $R_{GS(DC)}$: 等于栅源电压与栅极电流之比。
二. 交流参数
-
低频跨导 $g_m$: 表示 $U_{GS}$ 对 $i_D$ 控制作用的强弱,即 $i_D$ 与 $U_{GS}$ 变化量之比:
$g_m = \frac{\Delta i_D}{\Delta U_{GS}}|\text{常数}\ U_{DS}$
-
极间电容:场效应管的三个极之间均存在极间电容。
三. 极限参数
-
最大漏极电流 $I_{DM}$: $I_{DM}$ 是管子正常工作时漏极电流的上限值。
-
击穿电压:管子进入恒流区,使 $i_D$ 骤然增大的 $U_{DS}$ 称为漏源击穿电压 $U_{(BR)DS}$。
-
最大耗散功率 $P_{DM}$: $P_{DM}$ 决定于允许的温升。